【48812】WD4000系列晶圆几许量测体系:全面支撑半导体制作工艺量测保证晶圆制作工艺质量
抛光工艺的影响:抛光不均匀,有几率会使CMP进程中的不均匀抛光,然后构成外表粗糙和残留应力。
对薄膜堆积工艺的影响:凸凹不平的晶圆在堆积进程中会导致堆积薄膜厚度的不均匀,影响随后的光刻和蚀刻进程中创立电路图画的精度。
对光刻工艺的影响:影响聚集;不平坦的晶圆,在光刻进程中,会导致光刻焦点深度改变,从而影响光刻图画的质量。
对晶圆装载工艺的影响:在主动装载进程中,凸凹的晶圆简单损坏。如碳化硅衬底工艺流程中,一般还会在切开工艺时留有余量,以便在后续研磨抛光进程中减小TTV、BOW、Warp的数值。
TTV描绘晶圆的厚度改变,不量测晶圆的曲折或翘曲;BOW衡量晶圆曲折程度,首要衡量考虑中心点与边际的曲折;Warp更全面,衡量整个晶圆外表的曲折和翘曲。虽然这三个参数都与晶圆的几许特性有关,但量测的关注点各有不同,对半导体制程和晶圆处理的影响也有所区别。
WD4000晶圆几许量测体系可主动丈量Wafer厚度、曲折度、翘曲度、粗糙度、膜厚 、外延厚度等参数。该体系可用于丈量不同巨细、不一样的资料、不同厚度晶圆的几许参数;晶圆原料如碳化硅、蓝宝石、氮化镓、硅、玻璃片等。它是以下丈量技能的组合:
三维概括丈量技能:对Wafer标明上进行光学扫描一起树立外表3D层析图画,高效剖析晶圆外表描摹、粗糙度、丈量镭射槽深宽等描摹参数;
白光干与光谱剖析仪,可通过数值七点相移算法核算,以亚纳米分辨率丈量晶圆外表的部分高度,并完成膜厚丈量功用;
宣布的勘探光在 Wafer不同外表反射并构成干与,由此核算出两外表间的间隔(即厚度),适用于丈量外延片、键合晶圆几许参数。
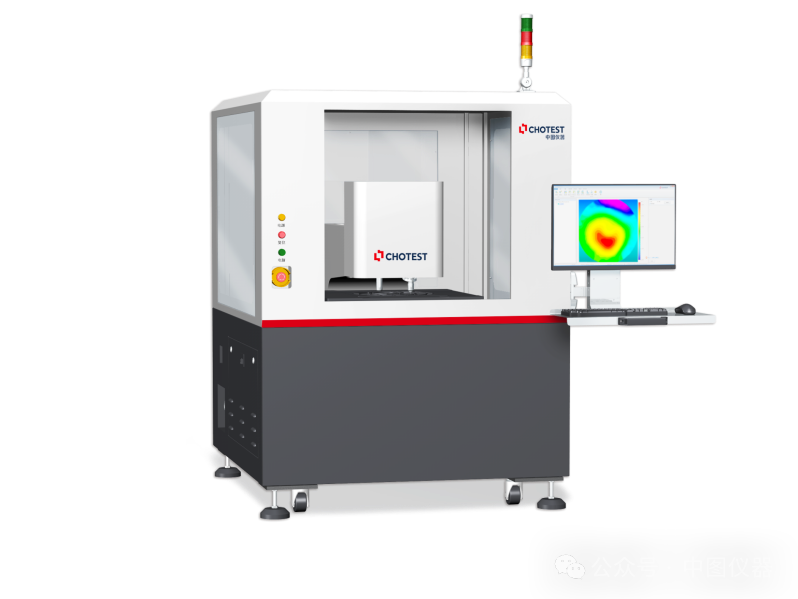
WD4000无图晶圆几许量测体系已大范围的使用于衬造、外延制作、晶圆制作、晶圆减薄设备、晶圆抛光设备、及封装减薄工艺段的量测;掩盖半导体前道、中道、后道整条工艺线。该体系不只大范围的使用于半导体职业,在3C电子玻璃屏、光学加工、显现面板、光伏、等超精细加工职业也大幅铺开使用。

架上,放入充溢氮气的密封小盒内避免在运送进程中被氧化或沾污十、发往封测Die(裸片)通过封测,就成了咱们电子数码产品上的芯片。
中的操作者,因为人是净化间中的首要沾污源。因为芯片快速向超大规模集成电路开展,芯片规划办法改变、特征尺度减小。这些变
芯品# MPQ6653具有集成功率MOSFET和嵌入式霍尔传感器的单相无刷直流 (BLDC) 电机驱动器
从PW1558A中文规格书看电源维护新高度:6A双向限流技能的完美演绎

